电子封装仿真及仿真结果轻量化专题(6月15-18日)
影响封装缺陷和失效的因素是多种多样的, 材料成分和属性、封装设计、环境条件和工艺参数等都会有所影响。影响因素可以通过试验或者模拟仿真的方法来确定。通常来讲,封装的负载类型可以分为机械、热、电气、辐射和化学负载。
本期6月15-17日专题课程,分别从综合负载因素、热、机械三个角度,对电子封装可靠性仿真分析进行讲解,包括“Sherlock电子产品可靠性分析“,”电子封装中的回流焊分析“和“LS-DYNA的跌落仿真”。每天1讲,每讲包括课程讲解和现场答疑两个部分,欢迎感兴趣的用户免费报名听课。
此外,邀请合作伙伴公司在6月18日带来“大数据压缩机显示工具vcollab“介绍,满足仿真工程师在日常工作中时常面临仿真计算结果轻量化的需求,可以帮助用户实现CAE数据多学科可视化及协同的虚拟平台构建。


第1讲:电子封装中的回流焊分析
封装结构中不同材料之间存在热膨胀系数差异,电子封装在回流焊温变过程中会产生翘曲变形。结构的翘曲会影响封装结构的共面度,引发芯片断裂、界面分层和焊点装联缺陷等质量和可靠性问题。因而,掌握回流焊仿真分析技术,对提高产品封装质量、优化电子封装中回流焊的温度设置具有相当重要的意义。

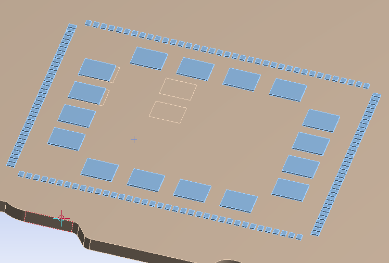
回流焊是一个过程,因此在分析中需要进行瞬态的热分析,施加的载荷也需要考虑到随时间变化的对流换热。在进行电子封装回流焊有限元仿真时,ANSYS Mechanical提供了热分析和结构分析两种分析类型,能满足回流焊过程中对温度的评估和对翘曲的预测。
通过本次课程,了解如何采用ANSYS Mechanical进行回流焊分析,并了解分析中的重点和难点。


第2讲:Sherlock电子产品可靠性分析
ANSYS Sherlock是一款针对电子产品可靠性分析的设计软件,它使用可靠性物理分析方法,直接解析EDA文件并利用逾30万个组件(部件、封装、材料、焊点、层压材料)构成的大型内部嵌入式部件库快速生成FEA模型,而后工程师们可以分析他们的产品承受各种不同环境应力,如温度和功率循环、谐波振动、机械冲击和弯曲等条件下产品的可靠性,以帮助确保产品的可制造性,并最大限度延长产品使用寿命。


第3讲:基于ANSYS LS-DYNA的跌落仿真应用及案例
跌落问题是在经济建设和生产实际生活中经常大量遇到的问题。以前的试验几乎都是对产品样机进行实物试验,实验作用时间很短,不易控制,而测得的物理量也很有限,无法获得空间和时间上的连续结果,不能完整显现跌落过程的结构响应和结构振动变形机理。此外,实物试验所带来的结果是增加成本,延长产品生产周期,适应不了当今科技发展的步伐,更失去占领市场的先机。
用ANSYS 进行计算机仿真,可以得到我们关注的参数,如结构整体应力变形,结合不同工艺参数,找到适当的工艺过程,这样不但使产品抗跌落、耐冲击的能力得到提高,而且还弥补了实物试验的不足。
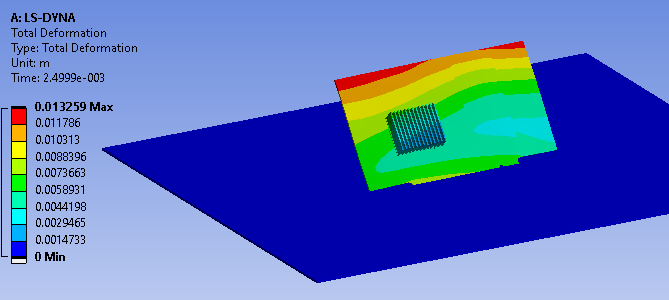



仿真工程师在日常工作中时常面临仿真计算结果轻量化的需求。VCollab是第一个实现CAE数据多学科可视化及协同的虚拟平台,是第一个为实现CAD/CAE/CAM数据的多学科可视化及协同的虚拟平台,是一种通用的PLM可视化解决方案。


报名方式
